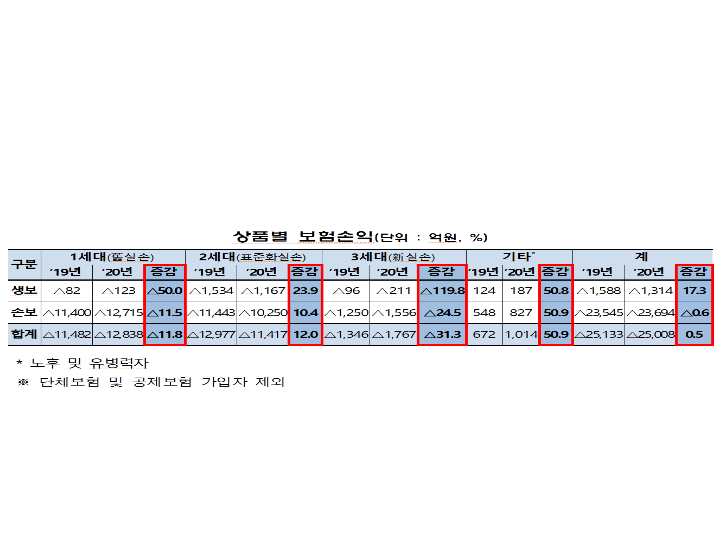
인더뉴스 이진성 기자ㅣ실손의료보험이 5년 연속 적자를 이어간 것으로 나타났습니다. 금융당국은 실손보험금 누수의 원인으로 꼽히는 비급여 진료에 대한 지급 심사 강화를 유도하기로 했는데요. 일각에선 실손보험금 인상이 불가피할 것이란 의견도 나옵니다.
29일 금융감독원에 따르면 실손보험 판매사들은 지난해 2조5000억원 적자를 냈습니다. 2016년부터 5년째 적자로, 손해보험사 손실이 2조3694억원, 생명보험사 손실이 1314억원에 달합니다. 매년 실손보험 보험료가 큰 폭으로 오르는데도 손실이 커지는 모습입니다.
금감원은 치료비가 비싼 비급여 항목에 대한 보험금 청구가 갈수록 늘어난 데다 의료기관의 과잉 진료를 통제할 장치가 부족한 것을 주요 원인으로 보고 있습니다. 실제 실손보험 보험금 중 비급여 비중은 63.7%로 전체 건강보험의 비급여 비중(45.0%)보다 훨씬 높은데요. 금감원은 비급여 항목에 대한 합리적인 보장 기준을 마련해 지급 심사 강화를 유도할 방침입니다.
보험료 인상 요인을 분석하기 위한 목적으로 비급여 보험금 통계 관리도 강화하기로 했습니다. 금감원 관계자는 “실손보험이 제2의 국민보험으로 지속될 수 있도록 상품구조 개선 및 비급여 관리강화 등을 지속 추진할 것"이라며 "꼭 필요한 치료비는 보장을 확대하고, 소수의 과다 의료이용이 선량한 다수의 보험료 부담으로 전가되지 않도록 감독을 강화하겠다"고 말했습니다. 다만 수차례 오른 보험료 인상에도 수년째 적자를 기록해왔다는 점에서 특히 서민경제에 부담을 줄 것이란 우려도 나옵니다.





![[3분기 실적] 롯데하이마트, 누적 영업익 184억원…3분기 연속 수익성 개선](https://www.inthenews.co.kr/data/cache/public/photos/20251044/art_17618778599179_f7220b_120x90.jpg)
![[3분기 실적] KB금융 순익 5조 깨고 전인미답 6조 향해 간다](https://www.inthenews.co.kr/data/cache/public/photos/20251044/art_17618244330917_f81756_120x90.jpg)












